
KAIST가 반도체 성능을 떨어뜨리는 전자 트랩을 1000배 더 민감하게 찾아내는 새로운 분석 기술을 개발했다.
전자 트랩은 반도체 결정 내부의 결함이나 불순물 등으로 생기는 일종의 '전자 함정'으로, 반도체 성능을 좌우하는 핵심 요소다.
전자가 반도체 안을 흐르다가 이 함정에 빠지면 누설 전류를 만들고 반도체 소자의 성능을 떨어뜨린다.
특히 메모리 반도체의 데이터 처리 능력을 방해하거나 태양전지의 에너지 변환 효율을 낮추는 등 소자의 신뢰성에 직접적인 영향을 미친다.
따라서 반도체 성능을 정확히 평가하려면 전자 트랩 양이 얼마나 되는지, 전자를 얼마나 강하게 붙잡는지 알아내는 과정이 필수다.
한 번의 측정으로 결함과 이동성 동시 파악
KAIST 신병하 교수팀과 미국 IBM 연구소 오키 구나완 박사팀은 전자 트랩과 전자의 이동 특성을 동시에 분석할 수 있는 새로운 측정 기법을 개발했다.
연구팀은 전기와 자기장을 이용해 전자 움직임을 분석하는 기존 홀 효과(Hall effect) 측정 방식에 주목했다.
연구팀은 여기에 빛을 비추는 포토홀(Photo-Hall) 측정과 온도 변화 변수를 결합해 전하 수송·트랩 특성 분석 포토홀(CTRPH) 기법을 완성했다.
이 기술은 빛 세기에 따른 전자 움직임 변화를 이용한다.
빛을 약하게 비추면 새로 생긴 전자들이 트랩에 먼저 갇히지만, 빛 세기를 높여 트랩을 가득 채우면 이후 전자들은 자유롭게 이동하기 시작한다.
연구팀은 이 과정에서 전도도 그래프가 휘어지는 쌍곡선 형태 비선형 거동을 수학적으로 분석해 트랩 밀도와 에너지 준위를 정밀하게 계산했다.
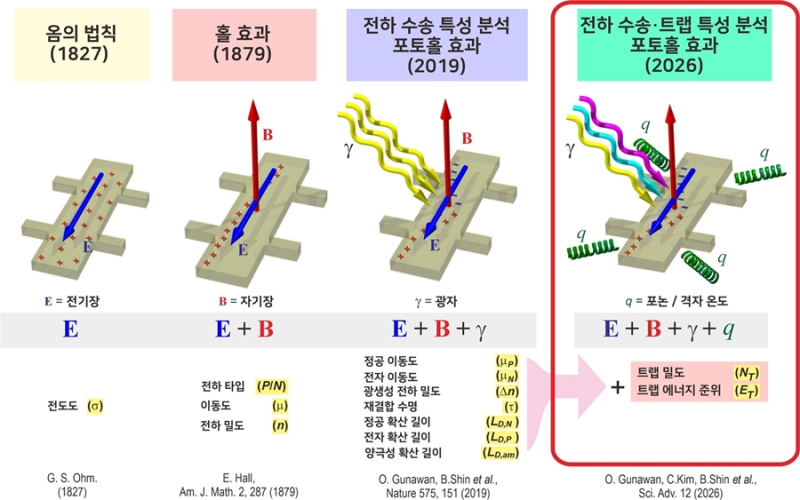
이 분석법은 별도 접합 구조를 만들지 않고도 한 번 측정으로 여러 정보를 동시에 얻는 장점이 있다.
전자가 이동하는 속도, 살아남는 시간, 이동 거리뿐 아니라 전자를 방해하는 트랩 특성까지 함께 파악한다.
연구팀은 실리콘 반도체와 차세대 태양전지 소재인 할라이드 페로브스카이트 박막에 이 기법을 적용해 유효성을 검증했다.
그 결과 기존 방식으로는 검출하기 어려웠던 아주 적은 양 결함까지 정밀하게 찾아내며 기존 기술보다 약 1000배 높은 측정 민감도를 확보했다.
이 기술은 반도체 불량 원인을 정확히 찾아내 개발 비용과 시간을 크게 줄일 것으로 기대된다.
신 교수는 "이번 연구는 반도체 안 전기 흐름과 방해 요인을 하나의 틀 안에서 동시에 분석할 수 있는 새로운 방법을 제시했다"며 "메모리 반도체와 태양전지 등 다양한 소자 성능과 신뢰성을 높이는 중요한 도구가 될 것"이라고 설명했다.
한편, 이번 연구는 김채연 KAIST 신소재공학과 박사과정이 제1저자로 수행했고, 연구결과는 지난 1일 국제학술지 '사이언스 어드밴시스(Science Advances)'에 게재됐다.
(논문명: Electronic trap detection with carrier-resolved photo-Hall effect)











